电子技术论坛
信息来源: 时间:2022-7-12
解析与衬底同型的注入强反型漏端电流模型
对于图6.10所示的连接方式,非饱和区的漏端电流可以据根式(4.4.13)确定,现将该式重写于下:

暂且假定μ为常数。[迁移率对栅电场的依赖性可以用有效迁移率方法来考虑(4.8节)。根据这个假定,并利用式(6.2.21)的Q´I,式(6.2.24)变成

假设VDB>VSB(VDS>0),我们分三种情况来说明漏端电流:
1、VSB<VDB≤VI。如果忽略十分靠近源和漏处的边缘效应,则在这种情况下,沿整个沟道长度,耗尽区都位于阶梯近似的注入区之内(图6.5)。把式(6.2.22a)和(6.2.6)代入式(6.2.25),给出

为使后面的公式表示在形式上紧凑一些,我们采用了这样一种表示法:

这个方程式具有式(4.4.8b)的形式。
2、VI≤VSB<VDB。这时,在整个沟道长度上,耗尽区的边位于阶梯近似注入区之外(图6.5b)。于是,把式(6.2.22b)手口(6.2.15)代入式(6.2.25)可得

式中I2由式(6.2.27) =2给出。
=2给出。
3、VSB<VI<VDB。这种情况下,耗尽区的边在源附近位于注入区之内,在漏附近位于注入区之外,(图6.5c)。正是在深度力 I处的某一点,反型层的反偏电压VCB等于VI。
I处的某一点,反型层的反偏电压VCB等于VI。
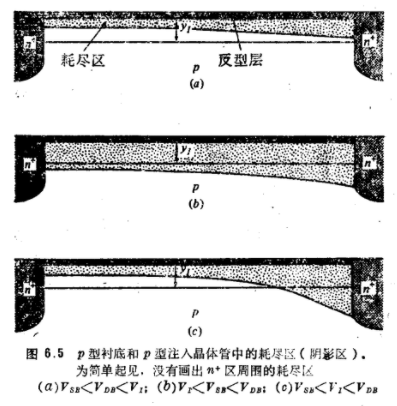
因此,式(6.2.25)可写成如下形式:

把式(6.2.6)代入第一个积分,把式(6.2.15)代入第二个积分,我们得到

其中Ii由式(6.2.27) =1,2给出。
=1,2给出。
饱和区的开始点可用第4章中那样的方法来获得,也就是ID与漏端电压关系曲线的斜率变为零的那一点。因为我们目前所用的电压是相对于衬底的,所以这个开始点定义为V´DB=V´DS+VSB。如果当V´DB<VI时出现夹断现象! 则通过令式(6.2.26)的斜率等于零,便有

如果当VDB在大于VI的某一值时出现夹断现象,则令式(6.2.28)或(6.2.30)的斜率等于零,可求得

如果VSB>VI,显然必须用式(6.2.32)来确定V´DB。假定VSB<VI,如果对于给定的VGB,式(6.2.31)所预计的V´DB值小于VI,则将用该式来确定V´DB。可是,如果式(6.2.31)所预计的V´DB的值大于VI,则这个值应该舍去,并改用式(6.2.32),因为在那种情况下,出现夹断时,沟道源端附近耗尽区的边位于注入区之外。如果沟道长度调制效应可以忽略,则通过在式(6.2.26),(6.2.28)和(6.2.30)的其中之一适当方程中用证确的V´DB代替VDB就可得到饱和电流:

包括非饱和区及饱和区的完整模型为:

离子注入器件中的沟道长度调制效应尚未得到很好地描述。因此经常使用非注入器件的模型(5.2节),不过对其中的参数用经验方法加以调整。
注入器件的ID-VDS特性的一般形状与非注入器件的特性相似, 但也确字存在一些特点。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




