电子技术论坛
信息来源: 时间:2022-7-6
MOS晶体管组合几种效应于一个模型之中分析
迄今今我们已经讨论了各种效应,为简单起见,每次只考虑一种。但是,在一个实际的器件模型中,必须同时考虑若干个这种效应。为了恰当地做到这一点,必须研究这些效应之间的相互作用,但遗憾的是,这样所得的表达式将变得十分复杂。如果每种效应独自的影响较小,则经常采用的一种经验方法是假设这些效应之间无相互作用。举例来说,考虑一个沟道底短又窄的器件。为了获得正确结果,这里需要用三维分析。然而,如果只是为了粗略地估算,对于这样一个器件,有时可利用有效阈值电压公式来建立模型,有效阈值电压 等于TT-∆VT-∆VT1,其中VT为长沟道阀值电压,∆VT为假设只存在短沟道效应时的阈值电压的减少量,∆VT1为假设只存在窄沟道效应时阈值电压的增加量。当∆VT和∆VT1较小时,可以证明,这种方法在某种程度上是正确的。
等于TT-∆VT-∆VT1,其中VT为长沟道阀值电压,∆VT为假设只存在短沟道效应时的阈值电压的减少量,∆VT1为假设只存在窄沟道效应时阈值电压的增加量。当∆VT和∆VT1较小时,可以证明,这种方法在某种程度上是正确的。
例5.4基于上述无相互作用的假设,作为一个建模的例子,下面我们设法来推导一个包括下列各种效应的漏端电流表达式:
1.L对有效阈值电压的影响
2.VDS对有效阈值电压的影响
3.W对有效阈值电压的影响
4.速度饱和效应
5.有效迁移率与垂直电场的相关性
6.饱和区的沟道长度调制。
这里所用的方法将是文献中所用方法的一个变种。前三项影响将用下面的有效阈值电压来模拟(参看前面的讨论):

式中的∆VT(L,VDS)和∆VT1(W)可按5.4节中所说的方法计算。第四种效应可像例5.2(5.3节)那样来模拟,第五种效应可利用式(4.8.18)来计入[参看式(5.3.11)下面的讨论]。
这样,在非饱和区有:

式中 (VDS)由式(5.5.1)给出。
(VDS)由式(5.5.1)给出。
漏-源电压的夹断值VˊDS可用5.3节中已说明的方法求出,即根据式(5.5.2)建立dID/dVDS=0的方程,并在计算中忽略VT与VDS的相关性。这样重又导出式(5.3.12)。通过更精确的计算可导出相当复杂的表达式,但所给出的值实际上仍与式(5.3.12)一样。
现在我们将确定饱和区的ID。这里需谨慎一些。如果像在5.2节中那样隐式地假定 ,与VDS无关,则我们可以采用式(5.2.5),其中的IˊD可由式(5.5.2)给出,此时式(5.5.2)中VDS要用VˊDS来代替。在最后的IˊD式中,VDS本身将不出现。情况当然应该是这样的,因为不管VDS的实际值是多少,被认为已夹断的沟道末端的电势(相对于源)总是假定为VˊDS。然而,正如式(5.5.1)已显式地指出的那样,我们在这里仍需计入VDS对
,与VDS无关,则我们可以采用式(5.2.5),其中的IˊD可由式(5.5.2)给出,此时式(5.5.2)中VDS要用VˊDS来代替。在最后的IˊD式中,VDS本身将不出现。情况当然应该是这样的,因为不管VDS的实际值是多少,被认为已夹断的沟道末端的电势(相对于源)总是假定为VˊDS。然而,正如式(5.5.1)已显式地指出的那样,我们在这里仍需计入VDS对 的影响。前面已经指出过,这一效应假定与夹断无关,不论VDS是大于或者小于VˊDS,它都存在,因为甚至当VDS>VˊDS时,沟道区也直接受到来自漏附近场强线的影响。因此,即使在饱和区,
的影响。前面已经指出过,这一效应假定与夹断无关,不论VDS是大于或者小于VˊDS,它都存在,因为甚至当VDS>VˊDS时,沟道区也直接受到来自漏附近场强线的影响。因此,即使在饱和区, 也将继续是VDS,而不是VˊDS的函数。从而有
也将继续是VDS,而不是VˊDS的函数。从而有

其中∆L/L用式(5.2.6)给出。这时,可能有人会提出异议,认为在分母的最后一个因式中应该用L-∆L,而不是L。然而,在当前这种经验建模的水平上,不值得这样考虑,因为两者的差别很小。最后,为了使ID(VDS)的斜率在VDS=VˊDS处连续,还将需要对VˊDS值略作修正,这已在5.2节中解释过了。
采用θB=0的上述模型已在别处提出,并与实验结果进行了比较,如图5.17所示。不过,由于4.8节中所讨论的原因,我们宁可考虑θB不等于零。
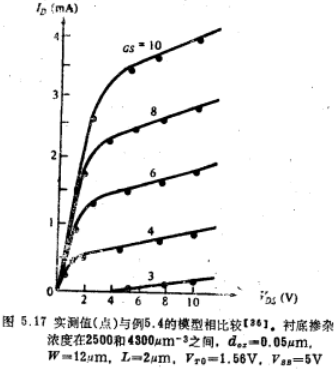
如在本节中所见,文献中大多利用有效阈值电压来研究短沟道和窄沟道效应。因此,显式地包含阈值电压的近似模型(4.4.30)式显然是较有用的。与此相反,精确模型(4.4.8)式没有显式地包含阈值电压,因而本节中的一些结果不能直接与它结合使用。这就使得近似模型被广泛地用于小器件。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




