电子技术论坛
信息来源: 时间:2021-11-12
详解MOS集成电路的故障类型及其原因和寿命试验方法
(1)统计处理
如欲逐一测量集成电路的寿命,在目前的技术条件下是不可能的。但可讨论一批集成电路的平均寿命。因此,统计处理极为重要。此处解释一下衡量可靠性的常用术语。
可靠性:系统、机器或元件等在规定条件下,在一定的时间内能正确执行规定功能的几率33)。
可靠性通常是与时间呈函数关系的几率,严格地说,它与表示一般概念的可靠性的意义不同。
可靠性函数R(t):开始使用到时间t不出故障的几率。
积累故障率F(t):开始使用后的积累故障率F(t)=1-R(t)
瞬时故障率λ(t):于时间t的故障率

平均故障时间间隔MTBF:系统或机器在两次故障之间能工作的时间的平均值。λ不变时,![]() 。
。
平均故障率![]() :是实际上有效的标准。以%/1000小时或10-9/小时(非特)作为单位。
:是实际上有效的标准。以%/1000小时或10-9/小时(非特)作为单位。
不能把MOS集成电路的可靠性当作各个分立的MOS场效应晶体管串联系统的可靠性来评价。MOS集成电路的故障。MOS集成电路需要作为一个电路整体来处理,但至今还没有发现适当的方法。正确求出上述各个时间函数极为重要,通常是设法运用已知分布形式,求得充分实用的函数。一般从λ(t)的定义可求得R(t)的函数形式如下。

即一般可作为指数函数来处理。例如对MOS集成电路按随机故障率λ施加某些峰值环境应力,设出现峰值应力时的MOS集成电路的故障几率为P(t)。MOS集成电路,在0到t的时间内不出故障的几率34)可用下式表示。

设峰值应力的出现遵循泊松过程,则出现n次峰值的几率为![]() 。因出现峰值应力时不出故障的几率可写作q(t)=1-P(t),于是
。因出现峰值应力时不出故障的几率可写作q(t)=1-P(t),于是

P(t)=1时(峰值应力出现后必然出故障的情形),P(t)=1-e-λt,称为按指数分布。作为更为有效的分布,有P=tm-1,![]() 的威布尔分布。MOS集成电路的故障。m>1时失效率随时间增加,为损耗型,出现于当应力很高时,所受应力被积累的场合。m<1时,失效率随时间减少,适合于弱应力时实用寿命的推算。将威布尔分布改写为
的威布尔分布。MOS集成电路的故障。m>1时失效率随时间增加,为损耗型,出现于当应力很高时,所受应力被积累的场合。m<1时,失效率随时间减少,适合于弱应力时实用寿命的推算。将威布尔分布改写为

如取纵轴为![]() ,横轴为log t,则得一直线。
,横轴为log t,则得一直线。
图3.153记有MOS集成电路的数据。

已有多种适用于推算半导体器件寿命的抽样表。典型的抽样表和由故障数目推测的平均故障率载于表3.24。

(2)故障物理学
由于MOS集成电路的故障率极小,用统计方法分析并预测故障十分困难。近年来,产生了一门学科,名曰故障物理学,对于了解故障现象的本质起了较大作用。因为查明故障机制后,既可谋求降低故障率,又可研究出适当的加速试验方法。表3.25列举了MOS集成电路的故障类型和原因。

表中没有写与其它半导体元件共同的失效类型,只举出MOS集成电路特有的失效类型。MOS集成电路从工作原理上看,是一种通过SiO2绝缘膜控制Si表面电荷的器件。器件表面、SiO2中。SiO2 Si界面以及Si表面的离子是产生不稳定性的原因。图3.164表示出成为不稳定性因素的离子35)。
(i)表面污染离子
除来自工艺过程中的封装气氛的湿度和表面污染外,还有因操作引起的静电荷和放射性射线的影响。栅电极等金属上的离子虽无严重影响,但SiO2上的离子起重要作用。肖克莱等人36)的实验示于图3.155。在P型硅衬底上扩散N型杂质,然后在其上覆盖一层SiO2,形成图3.155的结构,用开尔文探针测量知电荷呈均匀分布。如加20V的反向偏压,此电压出现于N型硅上,但离开P-N结处则测不出来。如湿度增高至100%,离开P-N结处亦可测出。撤除偏压后亦能检测出来,经高温干燥,则恢复到原来的状态。现介绍MOS集成电路上附着表面离子的实验例子37)。对于图3.156所示的MOS场效应晶体管结构,与栅电位相对应,来自栅电极的负的静电荷在SiO2上以![]() 的时间常数产生或消灭。SiO2漏泄的静电荷在SiO2下面产生反型层寄生沟道,漏的漏泄电流增大。严重时,即使切断栅信号,漏-源之间也导通,不能完成开关的截止动作,会出现误动作。图3.157给出寄生沟道电流与时间常数、相对湿度、栅电压和积累时间的关系。为了去除这种不稳定性,就要增厚偏置栅部分的SiO2层
的时间常数产生或消灭。SiO2漏泄的静电荷在SiO2下面产生反型层寄生沟道,漏的漏泄电流增大。严重时,即使切断栅信号,漏-源之间也导通,不能完成开关的截止动作,会出现误动作。图3.157给出寄生沟道电流与时间常数、相对湿度、栅电压和积累时间的关系。为了去除这种不稳定性,就要增厚偏置栅部分的SiO2层![]() 。金属电极膜充分覆盖SiO2层,就失掉了偏置栅。为了不降低表面电阻,就要降低封装气氛的相对湿度。使SiO2表面成为疏水表面等是有效的措施。
。金属电极膜充分覆盖SiO2层,就失掉了偏置栅。为了不降低表面电阻,就要降低封装气氛的相对湿度。使SiO2表面成为疏水表面等是有效的措施。

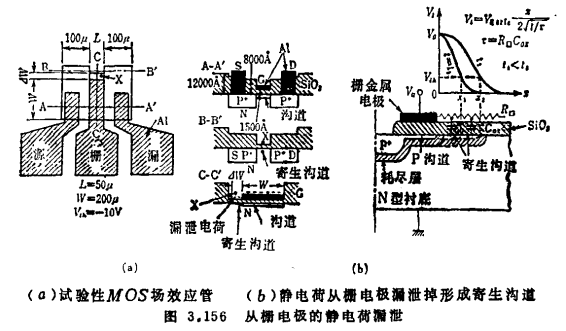

(ii)SiO2中的可动离子
与表面污染离子不同,在100~200℃的条件下,有离子在SiO2中垂直移动。如图3.158所示,根据萨支唐(C.T.Sah)等人38)的实验,由MOS结构特有的MOS电容-电压曲线的变化与极化电流大小相一致的事实,证实了SiO2中有正电荷的移动。根据推测和由放射性分析证实,这种正电荷主要是Na+,掺杂剂、纯水、石英管、炉体等材料中有很多Na+,是Na+的来源,采用P2O5捕获Na+或采用冷石英管壁高频加热法,可生长含极少Na+的SiO2膜,如图3.159所示39)。

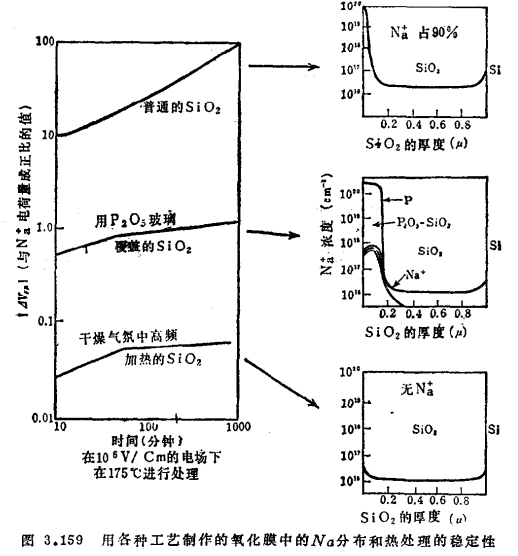
(iii)SiO2中的固定离子
即使采用完全防止Na+离子等污染的工艺制作MOS管,也会残留与衬底浓度及SiO2膜厚度无关的离子。这些离子经温-偏处理也不变化。在SiO2膜表面有过剩的氧或金属的氧化物,在Si界面附近则因Si过剩或氧空位而存在正电荷。Si的过剩也与晶轴有关,按(111)>(110)>(100)的顺序减少。
(3)可靠性试验方法
与其它半导体器件一样,MOS集成电路的故障率极小,为了进行MOS集成电路的可靠性试验就需要付出很多费用。加速寿命方法极为有效。一般来说越进行加速试验,就越出现实际使用状态的故障内容与加速试验时的故障内容不一致的矛盾。因此,必须在故障模式不变的范围内找出一种有效的加速方法。其中使威布尔分布的m不变,而只改变to的加速试验方法是可取的。根据MOS集成电路的设计,电压或功率的加速范围不可能取得很大,所以提高环境温度的方法是十分有效的。
如图3.160所示,与双极型集成电路相比,MOS集成电路的加速率较高。
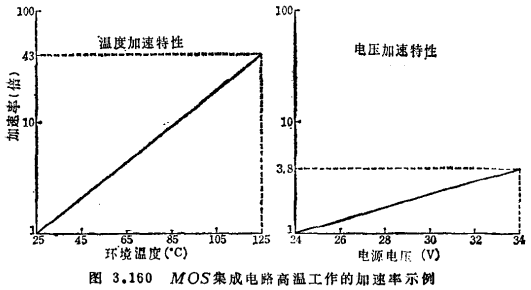
寿命试验方法与军用规格环境试验方法40)见表3.26。工作寿命试验中需注意的问题有:高温环形振荡器是将若干个集成电路串联起来,并将其输出端反馈到输入端,此法虽可节省振荡器的数目,但即便中间的集成电路短路,环形振荡器仍能工作,另一缺点是不能发现工作时各个集成电路特性的微妙变化。高温工作状态的测量,必须力求保持在原来的工作状态下进行,当恢复到室温并切断电源时,次品的特性有可能转好,这样就会误认为合格品。还应注意,电源通断产生的浪涌电压或控制炉温产生的浪涌电压等可使集成电路受到破坏;布线电容可引起波形失真,因而往往得不到正确的数据。

联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉大厦CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




